作者:MIR睿工业
在半导体制造中,一颗芯片需经历数百道工序,而任何细微的缺陷都可能导致终端产品失效。自动光学检测(AOI)设备作为制造流程中的“质量守门员”,其检测精度与效率直接决定着芯片良率与生产成本。过去十年,中国AOI检测设备市场经历了从PCB领域向半导体封装领域的跨越。
本文将分析中国 AOI 检测设备在封装领域的发展现状,依次探讨市场发展情况、竞争格局以及应用工艺需求。
01先进封装是半导体封装测试AOI市场增长的核心动力
AOI检测设备最初广泛应用于PCB(印制电路板)领域,用于检测光板、锡膏印刷、焊点质量等缺陷。近年来,随着半导体制造工艺的复杂化,AOI技术逐步渗透至半导体行业,覆盖晶圆制造、封装测试全流程,成为提升芯片良率的核心装备之一。
根据MIR DATABANK数据显示,2024年中国封装测试用AOI检测设备市场规模超12亿元,同比增速约为10%。
2022~2030年中国封装测试用AOI检测设备市场规模及预测-销售额(百万人民币)

数据来源:MIR DATABANK
AOI检测设备在半导体行业主要应用封装测试领域,该领域又分为传统封装和先进封装。
传统封装
- 在传统封装领域,AOI检测设备依然保持着较大的需求量,但传统封装所用AOI检测设备的单价远低于先进封装用AOI检测设备。因此,从整体市场规模来看,传统封装领域仅占不足20%。
- 近年来,BGA封装在传统封装领域发展迅速,Die Bond(芯片粘接)、Wire Bond(引线键合)以及成品外观检测等环节对AOI检测设备的需求明显增加。由于传统封装的检测精度要求相对较低,5μm的检测精度已能够满足其检测需求,因此传统封装领域的AOI设备价格相对不高。
先进封装
- 自2019年起,先进封装在中国市场蓬勃发展,成为推动AOI检测设备市场规模增长的核心动力。近两年,长电、华天、通富、禾芯、甬矽电子等企业在陆续新建先进封装产线,这明显推动了AOI检测设备市场需求的增加,使得先进封装领域占据了80%以上的AOI检测设备市场规模。
中国大陆先进封装项目最新进展-部分

信息来源:MIR 睿工业收集整理,MIR DATABANK
02中国AOI检测设备市场:Camtek一家独大
2024年中国封装测试用AOI检测设备市场竞争格局-销售额

数据来源:MIR DATABANK
根据MIR DATABANK数据显示,中国封装测试用AOI检测设备市场,Camtek一家独大,占比超过50%。
具体来看,传统封装用AOI与先进封装用AOI市场存在较大差异,二者厂商竞争相对独立:
- 先进封装用AOI市场:竞争格局较为集中,目前形成了以色列的Camtek、中国台湾地区厂商以及中国大陆厂商三足鼎立的局面。
- 传统封装用AOI市场:竞争格局较为分散。目前,除安维谱(MVP)和格兰达每年出货量较大且保持稳定增长外,其他厂商的年出货量均在个位数左右。
目前国内主流先进封装厂AOI检测设备品牌使用情况

信息来源:MIR DATABANK
目前,国产AOI检测设备厂商正在加快在先进封装领域的布局,如中科飞测、景焱智能等国产厂商已经在该领域打开了一定的市场,展现出较强的竞争力。与此同时,聚时、匠岭等国产厂商也在积极研发应用于先进封装领域的AOI检测设备。
国产量测、检测设备企业名录-部分

信息来源:MIR DATABANK,注册/登录数据库,可查询/下载更加详细的公司名录及公司信息。
03Bumping、晶圆切割、RDL三大工艺市场需求最高
在先进封装领域,AOI检测设备主要用于Bumping(凸点)、晶圆切割和RDL(重布线层)三大工艺环节。除此之外,在Chiplet(小芯片)和硅通孔(TSV)工艺中的应用也越来越广泛。在传统封装领域,AOI检测设备主要用于Wire Bond、晶圆切割、Die Bond三道工艺。
2024&2030年中国封装测试用AOI检测设备市场-6大应用工艺占比情况-销售额

数据来源:MIR DATABANK
Bumping是一种在半导体制造和封装领域中用于在芯片表面形成微小金属凸点(凸块)的工艺。这些凸点通常用于实现芯片与封装基板或其他芯片之间的电气连接,是现代半导体封装技术中的一个重要环节,尤其是在先进封装和3D封装中。Bumping的形成质量对封装的可靠性至关重要。目前,Bumping技术已广泛应用于倒装芯片(FC)、晶圆级封装(WLP)、系统级封装(SiP)以及2.5D/3D封装等领域,因此该工艺对AOI检测设备的使用需求较高。
晶圆切割(Wafer Dicing)是半导体制造过程中的一个重要环节,指的是将完整的晶圆(wafer)分割成一个个独立的芯片(die)的过程。这一工艺是所有封装类型中必不可少的步骤,并且在先进封装中尤为重要。由于晶圆切割需要确保芯片的完整性,因此目前该工艺对自动光学检测(AOI)设备有一定的使用需求。
RDL(Redistribution Layer,重布线层)是一种在半导体封装领域中用于重新分布芯片电气连接的技术,属于集成电路(IC)的先进封装解决方案。它允许将多个芯片集成到单个封装中,从而实现更小的封装尺寸和更高的性能。目前,RDL主要应用于倒装芯片(FC)和晶圆级封装(WLP)中。由于RDL工艺通常需要进行多层布线,且布线结构复杂,使得检测缺陷的难度大幅增加。因此,为了确保封装质量,通常需要配备多台AOI(自动光学检测)设备对每一道工艺进行检测。这也导致了RDL工艺对AOI设备的使用需求量较大。
先进封装领域AOI检测设备应用-技术难点分析
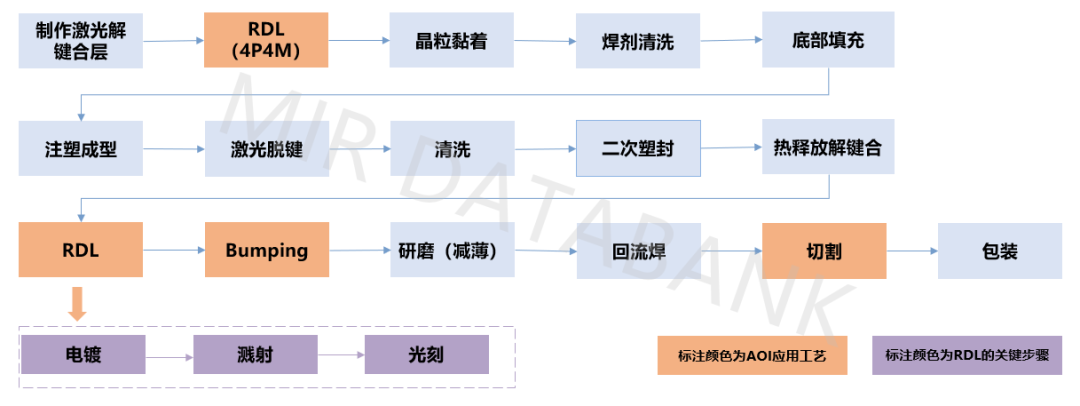
信息来源:MIR 睿工业调研,MIR DATABANK
以某家大型封装厂商为例,上图为其晶圆级封装的工艺流程图,目前用AOI检测设备的站点主要分布在RDL、Bumping、切割。
- 在切割过程中,技术难点在于检测产品边缘是否存在崩边时,如果产品边缘存在与崩边形状相似的金属部分,容易导致误检。
- 在Bumping过程中,技术难点主要集中在检测精度、误检率和数据处理速度上。在检测高度和共面性时,虽然一般的AOI检测精度为2μm,但实际需求精度需达到1μm以内;在检测少球和连球时,误检率需控制在5%以内;而在检测球间距和球的大小形貌时,对算法的数据分析和缺陷识别速度的同步性要求较高。
- 在RDL过程中,技术难点主要体现在检测连线是否存在缺口以及是否串联。目前,RDL工艺已经能够实现1.5~2μm的线宽和线距,这要求检测设备的镜头能力及精度达到亚微米级别。
传统封装领域AOI检测设备应用-技术难点分析
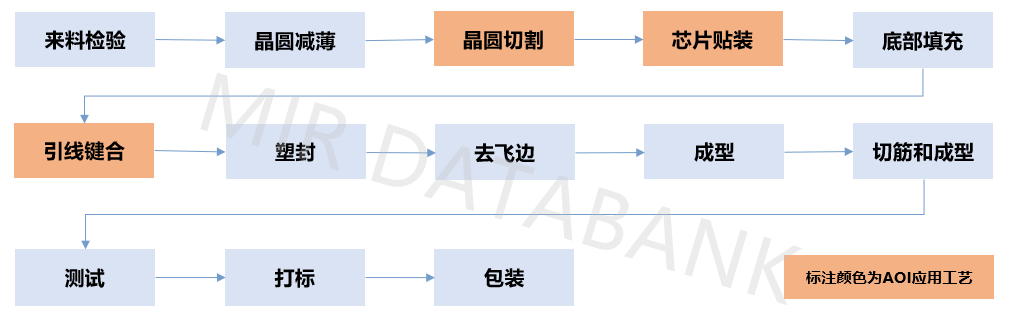
信息来源:MIR 睿工业调研,MIR DATABANK
以某家大型封装厂商为例,上图为其传统封装的工艺流程图,目前用AOI检测设备的站点分布在晶圆切割、芯片贴装和引线键合。技术难点主要在晶圆切割过程中,检测产品边缘是否存在崩边时,如果产品边缘存在与崩边形状相似的金属部分,容易导致误检。
写在最后
随着半导体封装技术的不断演进,AOI检测设备在提升芯片制造质量和效率方面的重要性愈发凸显。从传统封装到先进封装,AOI检测设备的应用场景不断拓展,市场需求持续增长。然而,技术挑战也日益严峻,特别是在Bumping、晶圆切割和RDL等关键工艺环节,对检测精度、误检率和数据处理速度的要求不断提高。
尽管市场竞争激烈,Camtek等国际巨头占据较大份额,但国产AOI检测设备厂商正在加速崛起,凭借技术创新和市场布局,逐步打破国际垄断,展现出强大的竞争力。未来,随着先进封装技术的进一步发展,AOI检测设备将迎来更广阔的应用空间和市场机遇。国产厂商需持续加大研发投入,提升技术水平,以更好地满足行业需求,推动中国半导体封装产业的高质量发展。
 芯耀
芯耀



 2854
2854







