提高功率密度和优化成本一直都是高效大功率应用的主要发展方向,尤其是在电动汽车等细分市场。为此,英飞凌宣布其应用于高压MOSFET的理想封装技术——QDPAK和DDPAK顶部散热(TSC)封装技术已成功注册成为JEDEC标准,以便尽快与行业上下游各环节的企业分享这一成果。同时,英飞凌于近日召开媒体会,由英飞凌科技电源与传感系统事业部大中华区应用市场总监程文涛,对该技术的工作机理、技术优势等做出深入解读。
程文涛全面阐述了英飞凌QDPAK、DDPAK顶部散热封装技术,从开发顶部散热封装技术的初衷,技术创新发展的过程,到适宜的应用和落地实践,再到如今成功入选JEDEC标准的原因以及对整个半导体行业的重要意义等,涵盖了方方面面。
对于功率半导体来说,过去十年的芯片设计一直在缩小尺寸、降低导通阻抗的道路负重前行。但近两年,硅芯片技术的Figure Of Merit系数(简称FOM值)基本到达了其物理极限,尤其是从高压超结的技术角度看,更是如此。在这种情况下,若想继续降低导通阻抗、提高能效,封装技术逐渐成为了业界亟需突破瓶颈的重要着力点。英飞凌的顶层散热(TSC)封装技术应运而生,取名为QDPAK,与之相伴的还有DDPAK。

在制造环节中简化装配、优化系统成本:
QDPAK是在业界所熟悉的DPAK基础上,即TO252封装的基础上演化而来。QDPAK大致相当于将4个DPAK并行排列,其封装尺寸大小也与4个DPAK相当,DDPAK则是两个DPAK并排(Double DPAK)。这两款封装所采用的顶部散热技术带来的主要益处就是无需堆叠不同的电路板,减少装配的过程步骤,简化制造流程;最终在下游厂商的制造环节中,还可以减少板与板之间的连接器数量,制成设备时板的数量或层级会减少,从而大幅降低装配成本和整体系统成本。
减少独立散热片的使用:
另外,随着下游厂商对于同尺寸内要传递更大功率耗散的需求不断增加,独立散热片的使用需求开始降低,同时却需要将更多的热量均匀散发到设备之外,顶部散热成了重要的解决方案之一。英飞凌的顶部散热技术便是通过放置隔离片和使用导热胶的方法,将所有并排摆放的顶部散热芯片的热量能够均匀地传导到一个平面的散热片上。相比其他方式,如锁螺丝、铜夹子、甚至焊接等方式,效果都要更加有效。
衍生问题与解决方案:
笔者深知,这样一项技术从研发到推广应用,过程中的难题绝非少数,因此也在媒体沟通会上询问,英飞凌顶部散热技术在研发的过程中遇到过怎样一些难解的衍生问题,并且英飞凌是如何去解决的。对此,程文涛提到,问题从技术诞生之处便一个接一个往外冒。从安规隔离片的固定方法,到软性导热胶等各种问题,所列一二只是冰山一角。但最终解决了各种问题,成果都将转化为技术经验和标准。
值得一提的是,测试过程中经常需要厂商自己去做很多的实验,去验证这个方式的可行性,这是英飞凌当初面临的巨大挑战,但后来因为越来越多的厂商敏锐地观察到了这种封装的优势,大家开始进行良性的互动。英飞凌作为上游供应商,充分调动了下游客户的积极性。因此,随着良性互动的越发频繁,遭遇的具体挑战虽然是多方面的,但是解决起来也越来越行之有效。
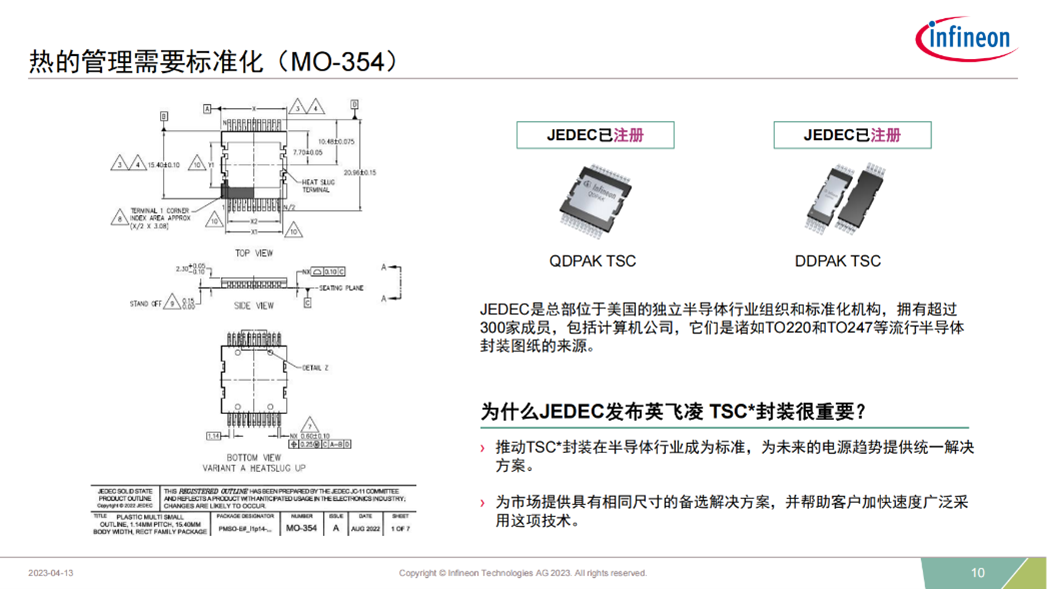
注册成为JEDEC标准三大动因:
至于将QDPAK和DDPAK顶部冷却(TSC)封装技术注册成为JEDEC标准,主要也是基于JEDEC这个标准组织有能力将行业里的一些创新想法快速推行开。JEDEC标准本身是免费的,技术在JEDEC标准组织中得到了注册和认证之后,其它的厂商可以免费从JEDEC标准组织里面下载及查看,厂家要做的就是制造符合这个标准的产品。因为已经跟业界通行的尺寸、安规都是相兼容的,所以为产品做推广的时候就更加方便。再者,JEDEC标准在半导体行业中认可度比较高。最后一点,在功率半导体领域业界有一个不成文的规定,任何一家厂商在选定一款功率半导体时,至少需要一个备选方案,理想的情况是有多种备选方案,也就是Multiple Source,所以标准本身就显得至关重要。
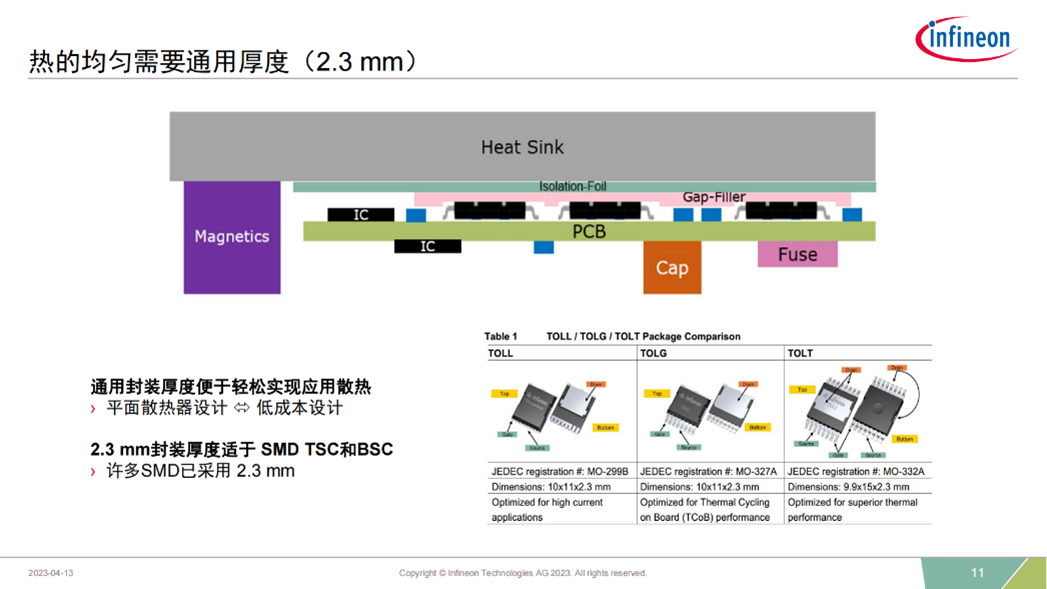
在这次媒体会上,英飞凌指出在相关的贴片封装中,统一器件的高度至关重要。英飞凌对于顶部及底部散热功率器件需要的通用封装厚度的定义为2.3毫米,并呼吁2.3毫米的厚度成为一个业界同行做法。关于选择这个厚度的缘由,程文涛表示首先要考虑到顶部散热的做法不能成为其它非顶部散热芯片的应用障碍。英飞凌研究了行业里很多的贴片封装尺寸,在大部分的非顶部散热以及顶部散热封装共存的情况下,2.3毫米成为了最优选项。因为2.3毫米的封装厚度能够让足够多的器件并存在同一块PCB板上。它可以允许客户用安规的绝缘片,再加上导热胶的方式,使所有的标准和非标准的封装都在同样一块PCB板上共存。
其实,早在2018年,英飞凌就发布过DDPAK的顶部散热概念及顶部冷却SMD封装技术,至今已有5年之久。程文涛坦言,过去三年中,英飞凌一直致力于跟客户积极沟通与磨合,使其理解、接受该技术,并在行业中得到认可。尤其是与头部客户的紧密合作,在定义封装技术时得到了很好的反馈。虽然受到了来自方方面面的阻力,如生产线方面的要求、安规方面的要求、甚至对散热材料配合的要求,但整个产业链都需要跟一些创新实践相配合,才能使一个创新技术最终真正落地。
一项成功的技术从发布走向成熟所需要的并不是发酵时间的长短,关键还是在于技术本身能够给产品、给行业带来怎样的价值。第一条碳化硅生产线诞生至今已超三十年,但碳化硅行业在最近两三年才开始爆发。英飞凌对于前沿技术的探索能力,以及对于先进封装技术的分享,值得敬佩,笔者也希望相关人士可以加入到这一行列中来,推动功率半导体行业高效发展。
来源: 与非网,作者: 顾子扬,原文链接: https://www.eefocus.com/article/1485583.html
 芯耀
芯耀




 2013
2013








