作者:畅秋
随着半导体制程节点的微缩,光刻机的行业地位不断提升,7nm制程芯片量产之前,DUV光刻机几乎统治了商业化芯片制造市场,随着7nm、5nm和3nm的陆续量产,EUV光刻机的比重日益提升,也成为了先进制程芯片龙头企业争夺的焦点。
眼看着DUV和EUV光刻机的大红大紫,以及ASML公司的春风得意,它们的竞争者也在摩拳擦掌,有几种不同于DUV和EUV的光刻技术在积蓄力量,争取获得更多的市场份额。
高NA光刻机争夺愈加激烈
随着半导体制程节点发展到3nm,先进晶圆厂对EUV光刻机的需求越来越迫切,具体来讲,就是台积电、三星和英特尔这三家,都在争夺ASML的EUV设备。
据悉,台积电拥有约50台EUV光刻机,接近市场上已出货EUV设备总量的50%。随着2nm研发和晶圆厂建设工作的开展,台积电对高NA(数值孔径)的EUV设备提出了更高要求,早早下单,争取在ASML那里拔得头筹。
三星也在紧急抢购高NA EUV,并要求ASML将设备直接拉到三星工厂内进行测试,创下ASML直接出货到客户厂内再测试的首例。目前,三星的EUV光刻机数量只有台积电的一半,甚至更少,预计2022年三星会购入大概18台EUV光刻机,拉近与台积电之间的数量差距,总数将达到台积电的60%左右。
2021年,英特尔宣布重返晶圆代工市场,并在同年7月宣布推出先进制程技术蓝图,计划在未来4年推出5个新世代芯片制程技术。为了实现这一目标,英特尔在争夺ASML最先进EUV光刻机,2021下半年,英特尔宣布领先于台积电和三星订购了ASML的TWINSCAN EXE:5200光刻机。这是ASML正在开发的高NA EUV设备,单台价格将达到3亿美元,据悉,其吞吐量超每小时220片晶圆。按照ASML的规划,TWINSCAN EXE:5200最快将于2024年底投入使用,用于验证,2025年开始用于芯片量产。
为了满足不断进化的先进制程,ASML正在研发更先进的EUV光刻机,主要体现在高NA上。
高NA的EUV设备具有更高的分辨率,可使芯片密度增加数倍,还可以显著减少缺陷、成本和芯片生产周期。
新的EUV设备,其NA值将从0.33 提升到0.55,以实现更高分辨率的图案化。和0.33NA光刻机相比,0.55NA的分辨率从13nm升级到8nm,可以更快更好地曝光更复杂的集成电路图案,突破0.33NA单次构图32nm~30nm间距的极限。EXE:5000有望率先用于3nm制程,EXE:5200则很可能用于英特尔未来的20A或者18A制程。
更高的NA值允许在机器内部产生更宽的EUV光束,然后再照射晶圆,该光束越宽,照射晶圆时的强度就越大,从而提高打印线条的准确度。这反过来又可以实现更小的几何形状和更小的间距,从而增加密度。
不过,高NA设备意味着高昂的价格,据悉,每台NA值为0.55的EUV设备价格将达到3 亿美元,是现有EUV设备的两倍,并且,它还需要复杂的新镜头技术。
目前,制造先进制程(如5nm、3nm)芯片的厂商不得不依赖双重或三重曝光技术,这很耗时,而使用高NA EUV设备,能够在单层打印这些特征,从而缩短周转时间并提高工艺灵活性。
EUV的竞争者
目前,在7nm以下先进制程芯片量产方面,EUV光刻机几乎是必选项,虽然DUV也可以用来制造7nm芯片,但其性能和良率与EUV相比还是有差距的,且随着制程节点的微缩,DUV就不能胜任了,EUV依然是首选。然而,高昂的价格使得台积电这样的晶圆代工龙头企业也要想办法减少EUV光刻机的使用量,以降低成本。
那么,是不是除了EUV光刻机,就没有其它选择了呢?答案是否定的,近些年,半导体业界一直在探索制造先进制程芯片的其它办法,例如:定向自组装 (DSA)、纳米压印光刻 (NIL)、等离子激光和EBL电子束光刻等技术。
DSA是一种通过将具有不同特性的聚合物合成为单个分子,将其涂覆在晶圆上并加热来获得精细图案的技术。由于不使用掩模,可以减少工艺数量,从而降低了成本。然而,就所使用的技术而言,它不如 NIL。此外,无掩模等离子激光纳米技术被认为是另一种替代方案,因为它具有自由改变电路图案的能力,然而,它仍达不到 EUV的效果。
综合来看,NIL是一项实用价值更高的技术,NIL比 EUV 更经济,因为它不使用镜头。佳能等厂商是NIL的主导力量。
NIL
NIL技术比EUV光刻起步晚,该概念由华裔科学家周郁(Stephen Chou)教授在1995年首次提出。它的基本原理是:使用电子束刻蚀等手段,在衬底上加工出所需要的结构作为模板。NIL将微电子加工工艺融合于印刷技术中,解决了光学曝光技术中光衍射现象造成的分辨率极限问题,由于电子的衍射极限远小于光子,理论上具备比EUV光刻更高的分辨率,可生产出电路线宽更窄的器件。此外,高效率、可大幅降低成本、适合工业化生产等优势,也使得NIL一直受到业界的重视,被称为是微纳加工领域中第三代最有前景的光刻技术之一。
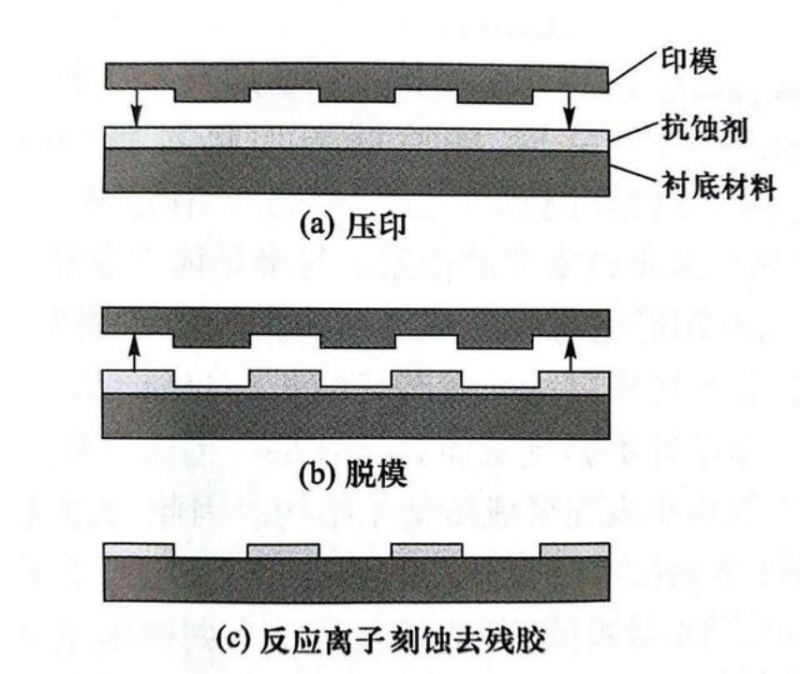
NIL 基于机械复制,不受光学衍射的限制。有专业人士指出,NIL技术能够制造出5nm制程芯片,且以非常低的成本实现非常好的关键缺陷 (CD) 控制。据Yole统计,NIL设备复合年增长率将超过 20%。目前,NIL主要用于增强现实、3D传感和数据通信/电信中需要严格和复杂模式的光学光子元件。
与EUV光刻设备产生的图案相比,NIL以更高的分辨率和均匀性再现图案。此外,由于这项技术不需要先进光刻设备所需的一系列宽直径镜头和昂贵的光源,NIL 设备实现了更简单、更紧凑的设计,允许将多个单元聚集在一起,以提高生产力。
NIL仅在必要时才使用抗蚀剂,从而消除材料浪费。鉴于压印系统中没有复杂的光学器件,当与简单的单级处理和零浪费相结合时,工具成本的降低使其非常适用于存储器制造。
制造先进制程DRAM 和相变存储器等存储芯片具有挑战性,因为这些器件的制程节点需要持续缩放,达到14nm,甚至更先进制程。缩放也会影响覆盖预算,例如,对于 DRAM,某些关键层上的叠加比 NAND 闪存紧密得多,误差预算为最小半间距的 15-20%,对于 14nm,这意味着 2.1nm - 2.8nm。DRAM 器件设计也具有挑战性,并且布局并不总是有利于间距划分方法,例如自对准双图案化 (SADP) 和自对准四重图案化 (SAQP)。因此,对于存储器芯片而言,直接印刷工艺NIL是一种很有竞争力的解决方案,特别是20nm以下先进制程,目前的光刻方案成本太高。
铠侠(Kioxia)与佳能,以及日本印刷株式会社(DNP),经过4年研发,实现了NIL量产技术。铠侠已将其应用到了15nm的NAND闪存制造上,并表示到2025年可以应用到5nm的芯片制造上。铠侠表示,与EUV光刻技术相比,NIL可以大幅度减少能耗,转化效率高,耗电量可压低至EUV 技术的10%,同时,NIL设备也很便宜,投资可降低至EUV光刻机的40%。
EBL电子束光刻
电子束光刻(e-beam lithography,EBL)刻蚀的工具是高能电子束,刻蚀的图案也是在光刻胶上,这种光刻胶型号以及曝光特性跟传统g-line,i-line或者DUV光刻胶略有区别。EBL不需要光刻掩膜版,想刻出什么图形,在人机界面用类似于EDA画图的方式直接输入。EBL光刻的精度非常高,多用于科研机构的研发,完成纳米级工艺毫无难度。
近期,美国公司Zyvex使用EBL技术制造出了0.7nm芯片。该公司推出了名为ZyvexLitho1的光刻系统,它基于STM(扫描隧穿显微镜),通过EBL电子束光刻,制造出了0.7nm线宽的芯片,这个精度远高于EUV光刻系统,相当于2个硅原子的宽度,是当前制造精度最高的光刻系统。
据悉,该光刻系统制造的芯片主要是用于量子计算机,可以制造出高精度的固态量子器件,以及纳米器件及材料。对量子计算机来说精度非常重要。
虽然EBL精度很高,但是速度太慢了,与传统DUV和EUV相比,生产速率是最大障碍,无法大规模制造芯片,只适合制作那些小批量的高精度芯片和器件。因此,在先进制程集成电路的大规模量产方面,DUV和EUV光刻机仍然难以取代。
结语
当下,DUV和EUV光刻机占领了大部分商业化量产芯片制造市场,但随着制程节点向3nm、2nm、1nm演进,愈加高昂的光刻机成本使得绝大多数晶圆厂望而却步,即使是台积电这样的龙头企业也不得不考虑削减EUV成本。这就给其它光刻技术提供了可能的发展空间。
除了商业化量产,很多科研领域也要用到光刻机,而DUV和EUV不太适合这些应用场合,这样,那些成本低、精度高的光刻技术就有了用武之地。
或许在不久的将来,会有更多光刻技术投入实际应用,各施所长,尽可能多地满足不同应用需求。
 芯耀
芯耀



 656
656







